OS-101
高精細収束イオンビーム装置 (ZEISS ORION NanoFab)
high definition focused ion beam system
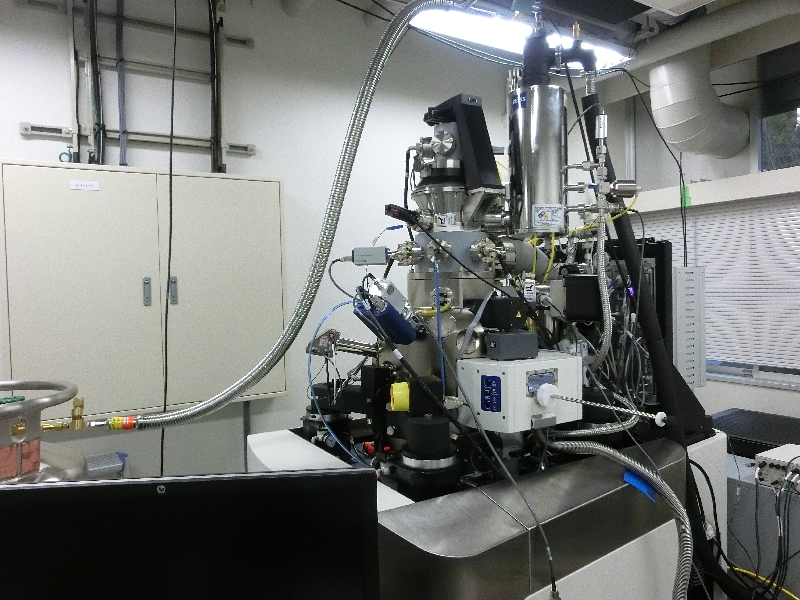
■ 特徴
イオン源に He ガスを採用し、最小ビーム径 0.5nm φ の分解能を有する装置。
【FIB】10nm 以下の微細加工が可能。
【ヘリウムイオン顕微鏡】(He / 0.5nm)中和銃装備のため、絶縁体を導電性処理なしで観察可能で、生体観察にも適している。
■ 仕様
イオン源:He / Ne(希ガス)
最小ビーム径:0.5nm(He)、1.9nm(Ne)
加速電圧:10 ~ 40kV
ET 検出器:二次電子
電子中和銃(Flood gun)装備
GIS:Pt, SiO₂, XeF₂
試料サイズ:45mm φ
設置場所:F-193
装置番号:F11
ARIM装置番号:OS-101